原子层沉积设备
加热式原子层沉积为一种气相化学沉积技术。大多数的ALD反应,将使用两种化学物质称为前驱物。这些前驱物以连续且自限的方式与材料表面进行反应。通过ALD循环的次数,缓慢的沉积薄膜。而热沉积式的ALD需要较高的制程温度(传统为150~350 oC)。
原子层沉积系统
ALD 用于薄膜沉积的原子层沉积是基于顺序使用气相化学过程的最重要技术之一;它可以被视为一种特殊类型的化学气相沉积(CVD)。多数ALD反应使用两种或更多种化学物质(称为前驱物,也称为“反应物”)。这些前驱物以一种连续的且自我限制的方式,一次与一种材料的表面反应。通过多个ALD循环,薄膜被缓慢沉积。 ALD为制造半导体元件的重要制程,并且是可用于合成纳米材料主要工具的一部分。
ALD具有许多优点,例如出色的均匀性,在复杂形状的基板表面上沉积的具有相同膜厚的膜保形性,低温处理。因此,ALD被应用于微电子,纳米技术和生物技术领域中,这些领域经常在有机和生物样品之类的软基底上工作。
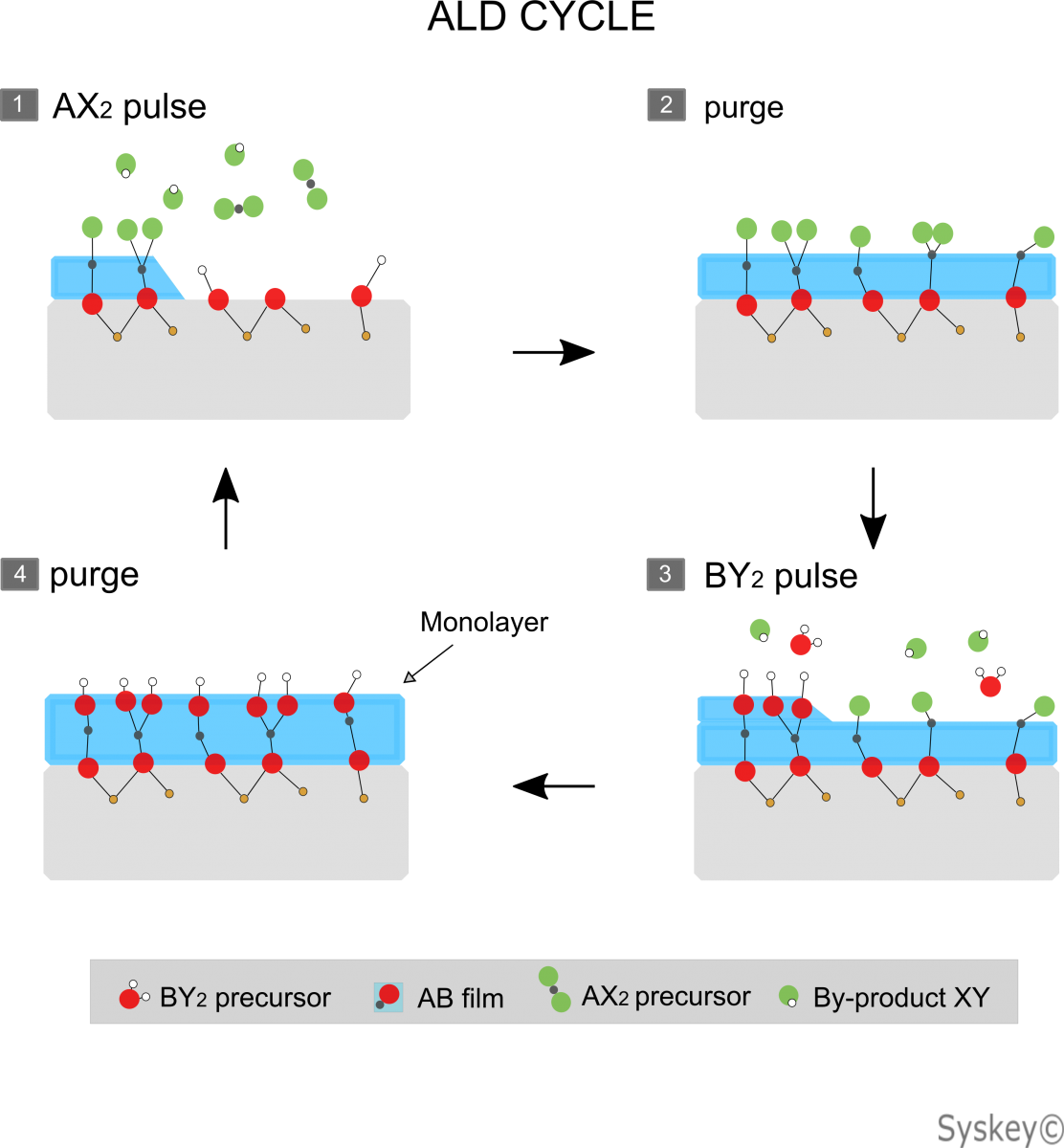
示意图-原子级薄膜沉积系统
厚度均匀度(WIW):
单个12英寸晶圆用于沉积目标厚度为5nm的Al2O3和HfO2膜。使用椭偏仪进行27点厚度测量并输入标准偏差公式。在±0.5nm范围内和均匀度的5%以内。
| Al2O3 均匀度=1.58% |
HlfO2 均匀度=1.27% |
.png) |
.png) |
介电常数和功函数:
准备三个矽晶片,并以固定的厚度沉积Al2O3 / TiN和化学氧化物/ HfO2 / TiN。测量三个样品的CV图以计算介电常数和泄漏电流:介电常数应为7〜9(Al2O3)和18〜22(HfO2),并且泄漏电流小于1 nA(@ 1V)。